微光電實驗室 ── 機台介紹:蝕刻類機台
Unaxis HDP
- 儀
 器中文名稱:高密度電漿蝕刻系統
器中文名稱:高密度電漿蝕刻系統 - 儀器廠牌及型號:Unaxis / Nextral 860L
- 設備規格:
- Plasma generator:
2000 W 2.45 GHz HF generator for HDP mode
300 W 13.56 MHz RF generator for RIE mode - Gas:
Cl2、BCl3、SiCl4、SF6、CH4、H2、Ar、O2、He、N2 - Real time access to numerous etching modes:
RIE、HDP、RIE+HDP - Etching depth:
End-Point Detector monitoring - Wafer Size: Max. 8inch
- Plasma generator:
- 儀器功用:化合物半導體乾性蝕刻
- 財產編號:3070114-003-0002
- 購置日期:2002年4月
- 廠商:百瑟
SENTECH ICP
- 儀
 器中文名稱:電感耦合電漿蝕刻系統
器中文名稱:電感耦合電漿蝕刻系統 - 儀器廠牌及型號:SENTECH SI 500
- 設備規格:
- Power:
ICP source power ≦ 1200W
RF power (substrate) ≦ 600W - Substrate heating:20℃~200℃
- Operating pressure:< 10mtorr
- Four gas line:BCl3、Cl2、O2、Ar
- Etch material:GaN、InP、Sapphire
- Wafer size:4inch
- Power:
- 儀器功用:乾蝕刻
- 財產編號:3070114-003-00377
- 購置日期:2006年12月
- 廠商:佳霖
RIE
- 儀
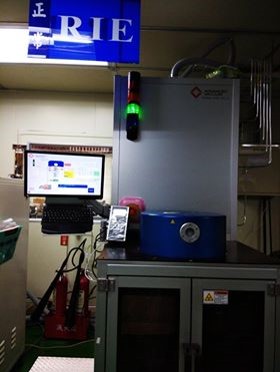 器中文名稱:活性離子電漿蝕刻系統
器中文名稱:活性離子電漿蝕刻系統 - 儀器廠牌及型號:Advance Vacuum /Vision 320
- 設備規格:
- RF Power:600W/13.56MHZ/auto-matching
- Wafer size:270 mm (max.) & pieces
- Operating pressure:< 100 mTorr
- Process gas:
H2、CF4、CHF3、SF6 、Ar 、O2 - Etching material:
Si 、SiO2、Si3N4 、PR 、BCB - Etching mask:PR、SiO2、Si3N4
- Etching Rate:
Si (20 nm/min.)、SiO2 (30 nm/min.)、Si3N4 (60 nm/min.) 、PR (40 nm/min.)
- 儀器功用:矽基材料及光阻之電漿乾蝕刻製程
- 財產編號:300114-003-379
- 購置日期:2012年10月
- 廠商:微士貿易有限公司
微光電實驗室 ── 機台介紹:沉積類機台
BMR CVD
- 儀
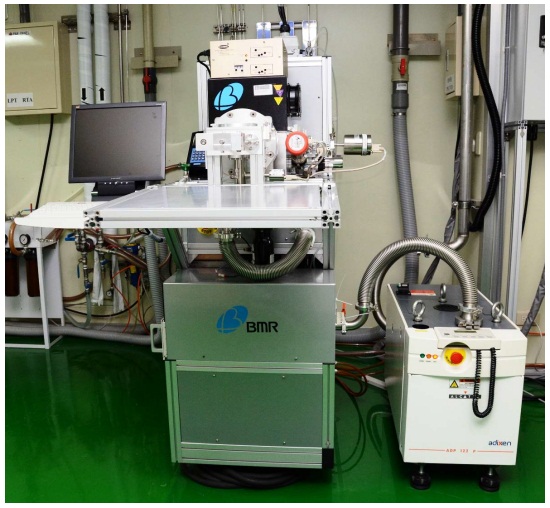 器中文名稱:感應式耦合電漿化學氣象沉積
器中文名稱:感應式耦合電漿化學氣象沉積 - 儀器廠牌及型號:BMR-FP2319R2
- 設備規格:
- Power supply:600W (CW) and 13.56MHz operation frequency
- Substrate heating:0℃~380℃
- Gas Cabinet:Ar、O2、SiH4、NH3、CF4
- Turbomolecular Pump:Over 40 liter/sec
- Mechanical Pump:Over 25cfm dry pump
- Electrical Power:AC 220V、45 Amper、3 phase、60Hz
- 儀器功用:低溫高密度之SiO2及Si3N4膜之沉積
- 財產編號:3013208-17-00001
- 購置日期:2006年12月
- 廠商:帆宣
SAMCO PECVD
- 儀
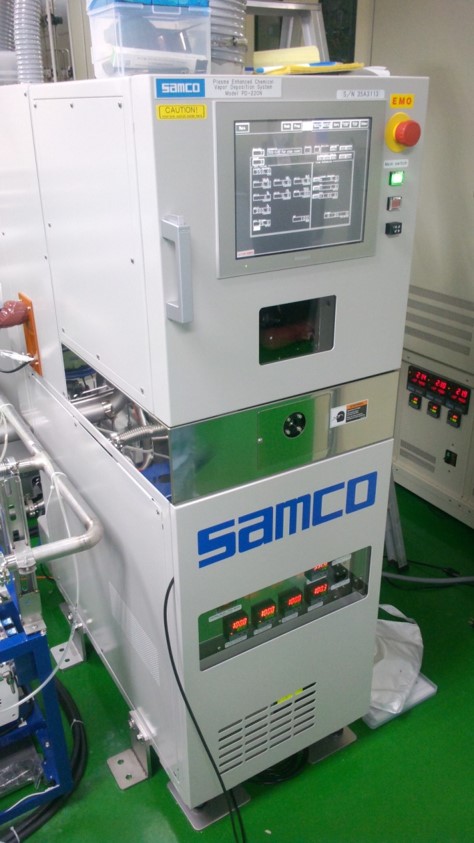 器中文名稱:電漿輔助化學氣相沉積系統
器中文名稱:電漿輔助化學氣相沉積系統 - 儀器廠牌及型號:SAMCO PD-220N
- 設備規格:
- RF Power:
300W /13.56 MHz / auto-matching - Operating pressure:< 700 mTorr
- Substrate Heating:
Up to 350℃ ±3℃@ ≧ 6” - Wafer Size:8” (max.) & pieces
- Process Gas:SiH4(10%)、N2、NH3、TEOS、N2O、CF4、O2
- Deposition Films:SiO2、TEOS-SiO2 、Si3N4
- Deposition Rate:SiO2 (≧ 50 nm/min.) 、
TEOS-SiO2 (≧ 50 nm/min.) 、Si3N4 (≧ 30 nm/min.)
- RF Power:
- 儀器功用:光電元件蝕刻阻擋層或鈍化層介質薄膜沉積製程
- 財產編號:3100103-586-243
- 購置日期:2013年12月
- 廠商:日商莎姆克
微光電實驗室 ── 機台介紹:蒸鍍類機台
Sputter
- 儀
 器中文名稱:離子濺鍍機
器中文名稱:離子濺鍍機 - 儀器廠牌及型號:HELIX
- 設備規格:
- Vacuum performance:5*10-5 torr (15min)
- Magnetron sputter cathode:4inch sputter source (2 set)
- RF power supply:1 KW
- DC power supply:3 KW
- Target:Si、W、SiO2、AlN、Si3N4、Al、ITO、IZO
- 儀器功用:濺鍍金屬及介質薄膜
- 財產編號:3100102-14-8
- 購置日期:2000年11月
- 廠商:和立聯和
- 改機日期:2011年3月
- 廠商:東銳
E-gun
- 儀
 器中文名稱:電子槍蒸鍍系統
器中文名稱:電子槍蒸鍍系統 - 儀器廠牌及型號:ULVAC EVA-E500
- 設備規格:
- Power supply:max. 300 W
- Substrate heating:0℃~300℃
- Working pressure:5*10-6 torr (20min)
- Metal source:Au、Al、Ni、Ti、Pt 、GeAu
- 儀器功用:蒸鍍金屬薄膜
- 財產編號:3100102-14-0010
- 購置日期:2001年3月
- 廠商:台灣日真
E-gun/Thermal
- 儀
 器中文名稱:高真空電子束暨熱阻式蒸鍍系統
器中文名稱:高真空電子束暨熱阻式蒸鍍系統 - 儀器廠牌及型號:ULVAC
- 設備規格:
- Power supply:
10 KW (e-gun), 5 KW (thermal) - Substrate heating:0℃~300℃
- Operating pressure:2*10-6 torr (20min)
- Crucible holder can be put four crucibles
- metal source:
Al、Ni、Ti、Pt、Au、Pd
- Power supply:
- 儀器功用:高品質金屬薄膜蒸鍍
- 財產編號:3100102-14-13
- 購置日期:2002年12月
- 廠商:優貝克
Thermal Coater
- 儀
 器中文名稱:高真空熱阻式蒸鍍系統
器中文名稱:高真空熱阻式蒸鍍系統 - 儀器廠牌及型號:I Shien SPS-302
- 設備規格:
- Power supply:max. 7.7 KW
- Working pressure:5*10-5 torr (20min)
- Wafer size:4inch
- Metal source:Au、Al、Ni、Ti、Cr
- 儀器功用:蒸鍍金屬薄膜
- 財產編號:3100102-14-163
- 購置日期:2009年2月
- 廠商:乙先
微光電實驗室 ── 機台介紹:退火類機台
Furnace
- 儀
 器中文名稱:高溫擴散退火爐
器中文名稱:高溫擴散退火爐 - 儀器廠牌及型號:海邦科技
- 設備規格:
- Tube (X3):
temperature range: 400℃~1200℃
heating zone Length: 250 mm (1200±1℃)
stability of internal furnace: 1200±1℃ - Gas of diffusion:
N2(flow-meter/0~10 SLM)
O2(MFC/0~10 SLM) - Gas of annealing:
N2(flow-meter/0~10 SLM)
Forming Gas(MFC/0~100 SCCM)
- Tube (X3):
- 儀器功用:擴散退火
- 財產編號:3100403-08-26
- 購置日期:2002年6月
- 廠商:海邦
ARTs-RTA
- 儀
 器中文名稱:快速退火爐
器中文名稱:快速退火爐 - 儀器廠牌及型號:Premtek / ARTs 150
- 設備規格:
- Chamber diameter:4 inch
- Cooing water:6 SLM, 30℃ max
- Compressed Air:5~6 kgf/cm2
- Temperature range:200℃~1200℃
- Heating rate max.:150 ℃/s
- 儀器功用:介質薄膜沉積(SiO2、Si3N4)
- 財產編號:3070114-003-0002
- 購置日期:2002年4月
- 廠商:百瑟
LPT-RTA
- 儀
 器中文名稱:快速退火爐
器中文名稱:快速退火爐 - 儀器廠牌及型號:LPT/ TM 100-BT
- 設備規格:
- Chamber Diameter:8 “ (max.)
- Chamber Water Cooling:
20 SLM @6 bar, 30℃ max. - Cooling Air:5~6 kgf/cm2
- Temperature range:200℃~1000℃ ±2℃
- Heating rate:100 ℃/s (max.)
- Wafer size:4” (max.) & pieces
- 儀器功用:離子佈植活化及材料熱退火處理
- 財產編號:3100401-33-146
- 購置日期:
- 廠商:
微光電實驗室 ── 機台介紹:量測機台
E-Beam Writer (II)
.jpg) 儀器中文名稱:電子束微影設備
儀器中文名稱:電子束微影設備- 儀器廠牌及型號:Raith / RAITH150-TWO
- 設備規格:
- Acceleration voltage:100 eV~30 KeV
- Probecurrent range:5 pA~20 nA
- Beam resolution:4 nm (30 keV)
- Current stability:≦ 0.5% / 8 hours
- Sample handling:full 4inch mask and wafer capability
- 儀器功用:電子束微影直寫奈米結構元件
- 財產編號:3100508-088-225
- 購置日期:2008年10月
- 廠商:技鼎
FE-SEM
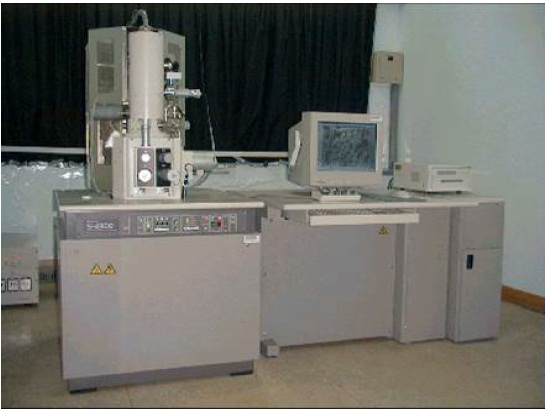 儀器中文名稱:場發射掃描式電子顯微鏡
儀器中文名稱:場發射掃描式電子顯微鏡- 儀器廠牌及型號:HITACHI S-4300
- 設備規格:
- Magnification:20x~250,000x
- Electron gun:Cold-cathode field
emission electron gun - Accelerating voltage:0.5 to 30 kV
- Specimen Stage
X movement:0 to 100mm
Y movement:0 to 50mm
Z movement:0 to 35mm
Tilt:-5°to 60°
Rotation:360°
Specimen size:Max.102mm
- 儀器功用:奈微米元件輪廓測量
- 財產編號:3100708-126-5
- 購置日期:2001年6月
- 廠商:益弘
Mask Aligner (Q)
.jpg) 儀器中文名稱:光罩對準曝光機
儀器中文名稱:光罩對準曝光機- 儀器廠牌及型號:Quintel / Q4000-6IR
- 設備規格:
- Mask size capability:5 inch
- Chuck X-Y Range:+/-6 mm
- Chuck rotation range:+/-7 degree
- Mask/Wafer Separation:0~180 μm
- Resolution:1μm
- 儀器功用:各種元件微影製程之對準曝光
- 財產編號:3100708-103-1
- 購置日期:2001年10月
- 廠商:晶友
UV-Ozone Stripper
 儀器中文名稱:紫外光臭氧清洗機
儀器中文名稱:紫外光臭氧清洗機- 儀器廠牌及型號:SAMCO / UV-1
- 設備規格:
- Sample stage:Aluminum, 200 mm (7.8”) diameter
- Maximum substrate size:150 mm (6”) diameter
- Substrate temperature control:controllable from
ambient to 300℃(570℉) ±1℃ - UV light source:110 W low pressure mercury discharge tube
- Timer:digital readout, auto shut off
- 儀器功用:微影製程殘存物之去除與清潔
- 財產編號:3101103-141-36
- 購置日期:2002年6月
- 廠商:日商莎姆克
Mask Aligner (MA6)
.jpg) 儀器中文名稱:光罩對準曝光機
儀器中文名稱:光罩對準曝光機- 儀器廠牌及型號:SUSS / MA6
- 設備規格:
- Mask & Wafer Size:5/7 inch;150 mm (max.) & pieces
- Exposure Mode:soft, hard, low vacuum, vacuum
- Exposure Source & Resolution:Hg lamp (350 W);
down to 0.8 μm - Alignment Methods:TSA & BSA
- Alignment Stage (X-Y-ϴ Range):X: +/-10 mm;
Y: +/-5 mm ; ϴ: +/-5。
- 儀器功用:各式光電元件之對準微影製程
- 財產編號:3100708-103-304
- 購置日期:2012年12月
- 廠商:休斯微
Alpha Step® Profiler
 儀器中文名稱:表面輪廓儀
儀器中文名稱:表面輪廓儀- 儀器廠牌及型號:KLA Tencor D 300
- 設備規格:
- Stylus forces:0.5 mg~15 mg
- Sample stage diameter:140mm(max.)
- Stage motion range:X-80;Y-20 mm(max.)
- Scan Length:30 mm (max.)
- Vertical range:1000 μm (max.)
- Vertical resolution:0.4 Å@1 μm
- Scan speed :10 ~ 400 μm/sec.
- Sampling Rate: 5~2000 Hz
- View Range:≧ 3760 x 3120 μm
- 儀器功用:膜層厚度及表面輪廓量測
- 財產編號:3100605-49-00165
- 購置日期:2017年12月
- 廠商:辛耘企業